 欢迎来到迈可诺技术有限公司网站!
欢迎来到迈可诺技术有限公司网站! 欢迎来到迈可诺技术有限公司网站!
欢迎来到迈可诺技术有限公司网站!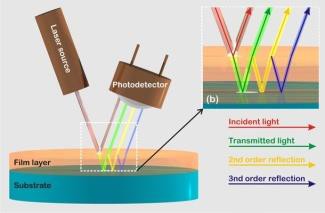
薄膜厚度均匀性和光学特性(N&K)是集成电路和MEMS制造过程中的一个关键参数。薄膜沉积控制可以产生高质量的图形,并确保在光刻步骤之后的器件性能。除了在半导体开发的步中对薄膜进行检查的必要性外,还需要在后阶段进行检查,在这一阶段进行封装(在集成电路顶部涂上一层涂层,以保护其免受物理损伤和腐蚀)。
在这里,我们使用了FR-Scanner来绘制两个商业光刻电阻的厚度图,这两个光刻电阻沉积在300毫米硅晶片上,用于封装应用。
FR-Scanner是一种工具,用于自动表征硅和其他尺寸达450 mm的基板上的单个或多个涂层,在精度和速度方面具有性能。
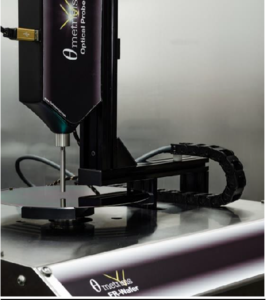
FR-Scanner
测量的方法:研究中的样品是300毫米硅晶圆片,每一个晶圆片上都涂有不同的商业光刻胶。所用的光阻剂为:HD8820和PW1000T,带有BARC涂层。所有测量均使用FR-Scanner工具进行,光谱范围为370-1020nm,能够非常快速可靠地测量从12nm到90um的涂层厚度。
该工具通过旋转夹头和在顶部线性移动光学头(极化扫描),在不弯曲反射探头的情况下,以非常高的速度扫描晶片,这对于测量至关重要。通过FR-Monitor生成的图案包括625个点位于(R,θ)位置,如右图所示,每次扫描持续大约1分钟30秒(以完成扫描和厚度测量)。

结果:
在下面的图像中,如在Fr监控软件上所示,显示了随机点上所有样品的典型获得的反射光谱(黑线)和拟合的反射光谱(红线),以及每个晶圆的映射轮廓。


扫描后,可以通过软件导出包含要编辑的各种参数的统计分析和厚度映射成像的报告。
对于统计参数的计算和点分布的表示,可以根据统计计算参数排除某些点。 这些被排除的点被视为“”点,可以以不需要的方式改变统计数据,因此用户可以排除它们。例如,在光刻胶HD8820的映射轮廓中,在该范围内包括625个点中的551个,因此晶片的合格区域代表其总面积的88.4%,在2D图中用颜色表示。 在PW1000T + BARC的映射配置文件中,625点中的614包括在该范围内,因此晶片的合格区域代表其总面积的98.4%。
结论:
使用FR-Scanner测量涂覆在300mm 硅晶片上的各种膜的厚度。 此外,通过厚度测量,晶片区域上的厚度映射和厚度均匀性的统计分析,成功地表征了膜。

FR-Monitor软件的屏幕截图